日本disco研磨机器

打印print
有关日本 总公司的研修中心 培训课程及培训手册 申请培训的流程 课程一览 培训费 2022年12月2日 DISCO HITEC CHINA 利用切割机、激光切割机、研削机等精密加工设备,切割刀片、研削磨轮等精密加工工具,以及将它们综合灵活运用的工艺技术,追求为 DISCO HITEC CHINA

减薄精加工研削 解决方案 DISCO HITEC CHINA
通过将原来的主轴上粗加工研削用磨轮所使用的陶瓷类结合剂(VS,VS202等)改变成树脂类结合剂 BT100 (照片4),能够降低晶片的破损率,并使导致晶片开裂的边缘崩 2024年2月4日 日本迪 思科 株式会社( DISCO Corporation )成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。 公司 半导体切磨抛设备前景展望 DISCO:全球半导体切磨抛设备

DISCO:一家少被提及的半导体设备巨头硅片刀片研磨机
2022年7月24日 DISCO:世界级封测设备巨头 DISCO是一家日本公司,其核心竞争力是将制造的半导体硅片研磨成更薄的硅片,然后将其切割成die,然后组装成电子产品。 他们 5 天之前 1月25日,迪斯科中国官微消息,为针对Si以及SiC等8英寸以下的晶圆,开发了双主轴全自动研磨机「DFG8541」。 该机型为畅销研磨机「DFG8540」的升级机型,实 DISCO推出新型自动研磨机,可加工8英寸SiC晶圆 艾邦

DISCO Corporation
2024年4月3日 为了要让您更有效使用并加深对机器的理解,开展各机种的操作及维修讲习。 试加工援助(演示加工) 为了确认是否能达到客户的要求,可在应用工程实验室进行 2023年7月15日 全球半导体设备材料巨头日本DISCO成立于1937 年,多年来专注于“Kiru (切)、Kezuru (磨)、Migaku (抛)”领域,形成了半导体切、磨、抛装备材料完善的产品布局,贯穿半导体全制程的重要工艺流程,凭借产品在精度、性能和稳定性上的优势,其减薄研磨 先进封装设备之争 日本减薄机独领风骚,国产研磨机步步紧逼

半导体切磨抛设备前景展望 DISCO:全球半导体切磨抛设备
2024年2月4日 DISCO:全球半导体切磨抛设备材料巨头专注半导体切割、研磨、抛光八十余载,产品布局完善日本迪 思科 株式会社( DISCO Corporation )成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。2021年7月6日 DFG8540/8560配置了触摸式液晶显示器及图 形化用户接口GUI(Graphical User Interface),提高了操作便利性。 而且设备的 机械状态和加工状况可在控制画面上同步显 示。 操作人员通过触摸控制画面上的图形化按 钮, 就可以简单地完成操作, 不但加快了作业 速度, 还使设备 Microsoft PowerPoint dfg8540 8560cppt DISCO HI

半导体设备公司:迪思科科技 Disco Corporation(DSCSY
2024年6月17日 迪思科科技Disco Corporation (DSCSY)美股百科 DISCO Corporation是一家日本精密工具制造商,特别是针对半导体生产行业。 公司生产切割锯和激光锯,以切割半导体硅晶片和其他材料; 用于将硅和化合物半导体晶圆加工到超薄水平的研磨机; 抛光机去除晶片背面的研磨 可對應DBG(Dicing Before Grinding=先切割,後研磨),以及和乾式拋光機(DFP8160)組成聯機系統。 透過改變研磨加工點提高品質可信度 透過主軸與第二主軸研磨加工點的位置統一,提高了第二主軸的研磨穩定性。DFG8560 研磨機 產品介紹 DISCO Corporation

广东基德科技有限公司DISCO划片机 研磨吸盘广东基德
2024年1月23日 1高精度:研磨吸盘采用高精度的研磨技术,可以确保吸盘表面的平整度和光滑度,从而保证划片机的精密度和稳定性2长寿命:研磨吸盘经过精细研磨和热处理,具有较高的硬度和耐磨性,使用寿命长,降低了更换吸盘的频率和维护成本3适用性强: 研磨吸盘可以 2023年3月2日 日本迪思科株式会社(DISCO Corporation)成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。公司产品矩阵以切、磨、 抛为纵深,设备和工具横向扩张,产品主要包括:1)半导体设备:切割机、研磨机、抛 光机及其他用于半导体加工后道切割和 半导体行业专题研究报告:半导体切磨抛装备材料的国产化趋势
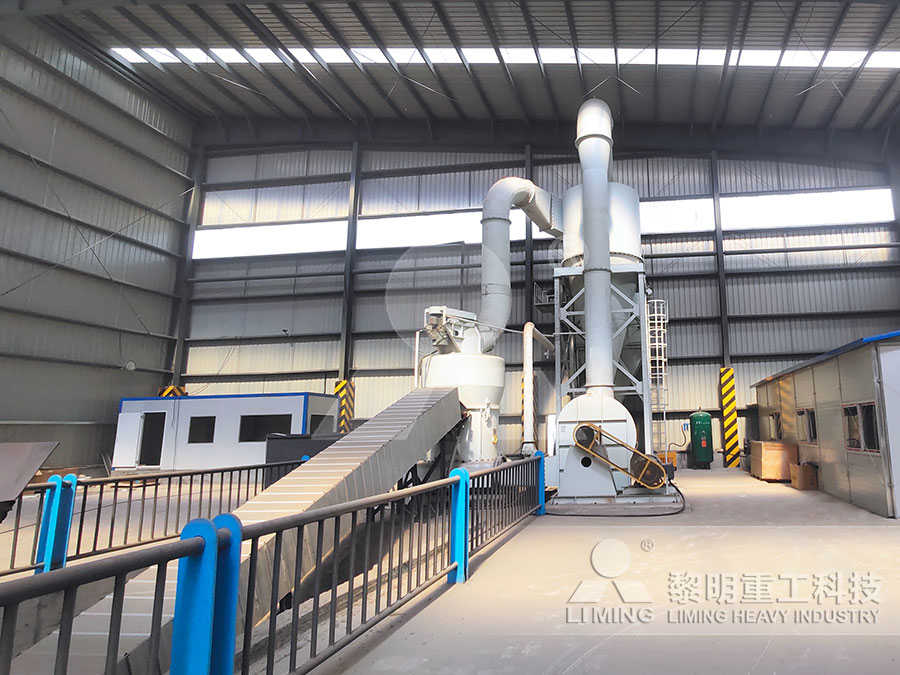
DISCO HITEC CHINA
20221202 迪思科科技(中国)有限公司南京分公司正式开业 2022420 新型冠状病毒相关讯息(第二十五份报告):新冠疫情下关于迪思科科技(中国)有限公司上海总部的最新办公情况 202118 新型冠状病毒相关讯息(第二十四份报告):伴随紧急事态宣言的 1 天前 DISCO关键无定型黑色重复吸收技术 日本DISCO公司研发出了一种称为关键无定形黑色重复吸收(key amorphousblack repetitive absorption,KABRA)的激光切割技术,以加工直径6英寸、厚度20mm的碳化硅晶锭为例,将碳化硅晶圆的生产率提高了四倍。顺应降本增效趋势,半导体碳化硅(SiC) 衬底4种切割技术

关于迪思科 迪思科集团介绍 DISCO HITEC CHINA
迪思科集团介绍 自创社以来,向全世界范围内1000家以上客户供应产品的迪思科,拥有从产品的研发、制造、试切试磨实验到售后服务的系统化支援体系,组成强大的迪思科全球网。 中国国内分支机构(不含港澳台地区):11处 国外分公司・代理店46处、制造 知乎 有问题,就会有答案

干式抛光法 (消除应力方法) DISCO Corporation
应用技术 通过在背面研削加工工艺中增加干式抛光工序,除去因研削加工而产生的研削变质层,能够进一步提高晶片的抗折强度。 使用干式抛光,主要可获得以下3种效果。 如图2所示,以球压式抗折强度的测试结果作为去除研削变质层的加工指标,我公司 2015年3月11日 ③进行粗研磨加工→ ④进行细研磨加工→ ⑤进行干式抛光加工(去除残余应力)→ ⑥用T2取物手臂将工作物从工作台移到离心清洗台上→ ⑦进行清洗→干燥→ ⑧移到贴膜机上(DFM2800)。或者由机械手臂将工作物送回到储料盒。 使用条件追求更高效率的300 mm研磨拋光机 DISCO HITEC CHINA

知乎 有问题,就会有答案
2024年3月5日 相较于常规的晶体 机械加工方式,此技术从原理上避免了锯口损失, 且晶体内部损伤较小,大大降低了SiC 在产业化技术方面,日本Disco公司与德国 Siltectra公司分别发布了适用于4~6英寸SiC晶锭整片 剥离的激光剥离技术,可大幅提高SiC晶体加工 SiC单晶材料的激光剥离技术研究进展

Grinding Wheels Poligrind DISCO HITEC CHINA
2015年3月11日 通过在纵向切入式研机的精加工研削轴(Z2 轴)上使用Poligrind( 抛旋光性研削磨轮),在不需要增加新设备及改变现有生产技术的条件下,亦可改善晶圆的精加工表面粗糙度和抗折强度,获得更高的加工质量。 能够在现有纵向切入式研削机上安装使用。 能够在不改 照片1、2所示的是厚度为25 µm的硅晶片(采用干式抛光法对背面进行研磨抛光)在加工后发生的背面崩裂状况。 由于照片1是以用于通常晶片厚度,由普通尺寸的磨粒构成的磨轮刀片(#2000)进行加工的,所以背面崩裂的现象 薄型晶片切割加工 刀片切割 解决方案 DISCO

日本DISCO晶圆设备推新:SiC切割设备面世 电子发烧友网
2024年1月12日 日本晶圆设备巨头DISCO于2023年末发布了全新SiC(碳化硅)切割设备,成功提升碳化硅晶圆切割速度10 Disco在切割、研磨和抛光机器 方面拥有全球最大的市场份额。安装在机器中的切割轮高速旋转以处理形成电路的基板。该装置由钻石制成,磨损 Figure 2 利用隐形切割加工进行蓝宝石加工 利用激光进行加工时,进给速度非常快,通常,激光加工的速度可达到金刚石划片机的数倍,可实现生产率的大幅提升。 只需输入加工参数,即可维持稳定的加工品质,完全不依赖于操作人员的技能水平。 全自动机器 利用激光进行蓝宝石加工 激光切割 解决方案 DISCO

斥资400亿日元,日本半导体设备大厂Disco将在广岛建新工厂
2024年1月16日 据了解,Disco预计将投资超过400亿日元(约合276亿美元)新建广岛新工厂,计划最早于2025年开始建设。 新工厂将生产用于晶圆切割、研磨和抛光过程的切割轮。 该公司预计,整体到2035年之际,公司的产能将提高14倍。 Disco CEO Kazuma Sekiya表示,“我们将采取 为了要让您更有效使用并加深对机器 的理解,开展各机种的操作及维修讲习。 有关日本总公司的研修中心 自动研磨机 DTG8440 适用于Φ200 mm 晶圆 全自动TAIKO研磨机 DTG8460 适用于Φ300 mm晶圆 全自动TAIKO研磨机 TAIKO工艺 TAIKO工艺 研削 解决方案 DISCO Corporation

减薄精加工研削 解决方案 DISCO HITEC CHINA
提高抗折强度(去除应力加工) 虽然通过采用Poligrind磨轮进行研削加工,可提高减薄精加工的加工质量。 但由于使用的是磨轮,所以在晶片表面仍然会残留下细微的破碎层。 为了去除表面残留的破碎层,进一步提高芯片的抗折强度,迪思科公司还可以根据 2023/04/20 最新消息 DISCO to Newly Introduce a Commitment Allowance System and Provide 100,000 yen per Month to Those who Apply 2023/04/13 最新消息 Sales Release for DFD6342:A Fully Automatic Dicing Saw That Supports Φ8inch Wafers 2023/03/31DISCO Corporation

先进封装设备之争 日本减薄机独领风骚,国产研磨机步步紧逼
2023年7月15日 全球半导体设备材料巨头日本DISCO成立于1937 年,多年来专注于“Kiru (切)、Kezuru (磨)、Migaku (抛)”领域,形成了半导体切、磨、抛装备材料完善的产品布局,贯穿半导体全制程的重要工艺流程,凭借产品在精度、性能和稳定性上的优势,其减薄研磨 2024年2月4日 DISCO:全球半导体切磨抛设备材料巨头专注半导体切割、研磨、抛光八十余载,产品布局完善日本迪 思科 株式会社( DISCO Corporation )成立于 1937 年,是一家专注于“Kiru(切)、 Kezuru(磨)、Migaku(抛)”技术的全球知名半导体设备厂商。半导体切磨抛设备前景展望 DISCO:全球半导体切磨抛设备

Microsoft PowerPoint dfg8540 8560cppt DISCO HI
2021年7月6日 DFG8540/8560配置了触摸式液晶显示器及图 形化用户接口GUI(Graphical User Interface),提高了操作便利性。 而且设备的 机械状态和加工状况可在控制画面上同步显 示。 操作人员通过触摸控制画面上的图形化按 钮, 就可以简单地完成操作, 不但加快了作业 速度, 还使设备 2024年6月17日 迪思科科技Disco Corporation (DSCSY)美股百科 DISCO Corporation是一家日本精密工具制造商,特别是针对半导体生产行业。 公司生产切割锯和激光锯,以切割半导体硅晶片和其他材料; 用于将硅和化合物半导体晶圆加工到超薄水平的研磨机; 抛光机去除晶片背面的研磨 半导体设备公司:迪思科科技 Disco Corporation(DSCSY

DFG8560 研磨機 產品介紹 DISCO Corporation
可對應DBG(Dicing Before Grinding=先切割,後研磨),以及和乾式拋光機(DFP8160)組成聯機系統。 透過改變研磨加工點提高品質可信度 透過主軸與第二主軸研磨加工點的位置統一,提高了第二主軸的研磨穩定性。